|
|
||||||||||
1980年代中頃 リフロー法からエッチバックによる平坦化に移行 〜プロセス技術〜 |
||||||||||
| 1970年代から使用されてきたリフロー法では、処理温度が高く(BPSGを使用しても800℃程度)、微細化の進展に伴うプロセスの低温化に適合しなくなって来た。特に、集積度の向上と共にAlの多層配線が多用されるようになってきたが、配線層間の絶縁膜の平坦化には高温のリフロープロセスは使えない。そこで登場してきたのがエッチバック法による平坦化技術であった。エッチバック法では、凹凸のあるCVD絶縁膜の上にフォトレジストをスピンコート(液状のフォトレジストを高速回転するウェーハに滴下して塗布)し、ウェーハをプラズマエッチング装置で全面エッチングする。スピンコートしたフォトレジストは下地の凸凹を埋めて表面は平らになっており、これをプラズマエッチングで削り取っていく(一旦付けたフォトレジストをエッチングによって取り除いていくのでこの工程をエッチバック工程と呼ぶ)。この時、フォトレジストと下地のCVD絶縁膜のエッチング速度が同じになる条件でエッチングを行うと、最初のフォトレジストの表面形状のままでCVD絶縁膜が削られて平らになる。なお、下地のCVD絶縁膜の凹凸をあらかじめ緩和するために、SOG(塗布型の絶縁膜)が併用されることが多かった。 エッチバック法が実用化されたのは、1980年代中頃になって異方性プラズマエッチング装置が広範に使われるようになったからであるが、平坦化のためには等方性プラズマエッチングでもかまわない。異方性プラズマエッチング装置(RIE)を使って、平坦化とは別の目的のエッチバック応用技術も開発された。具体的には、ポリシリコンゲートを形成後にCVD絶縁膜を付け、(平坦化とは異なりフォトレジストを塗布することなく)RIEでエッチバックを行って、ゲートの側壁部のみにサイドウォールと呼ばれる絶縁膜を残す技術であり、その後のトランジスタの微細化に重要な技術となる。 尚、1990年代後半になると更なる平坦化が要求されるようになり、CMPによる平坦化に移行していった。 |
||||||||||
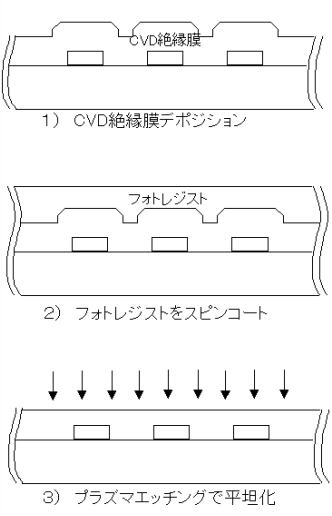 図 エッチバックによる平坦化工程 |
||||||||||
|
【参考文献】 【移動ページ】 プロセス技術/該当年代へ 【最終変更バージョン】 rev.001 2010/12/3 |