|
|
||||||||||
1970年代 リフローによる平坦化技術の採用 ~プロセス技術~ |
||||||||||
| シリコンゲートでは、ゲートと上層のAL配線の間の絶縁膜が下層のポリシリコンのパターンエッジで急峻な段差になる。このままでは、ALが段差部のカバレッジが悪くなり断線することから、平坦化の技術が必須となった。初期の技術は酸化膜にリンを高濃度にドープしたPSG膜を1000℃程度の高温で熱することで、表面が滑らかになり段差が緩和される技術が用いられた。 この方法には①高温加熱が必要で、それによる拡散層の拡散の増大が微細化の妨げとなった。また、②リフロー性を上げるために燐をあまり高濃度にすると、大気中の水分を吸ってALの信頼性劣化、などの懸念があった。その後、より低温(1000℃以下)でリフローするBPSG(酸化膜に燐とホウ素をドープしたもの)が使われるようになった。 これらの膜にはNa等の可動イオンをゲッタリング(膜中に固定して動かなくする)する性質もあり、トランジスタの信頼性向上と平坦化の一石二鳥の効果があった。 装置は、当初は常圧CVDが使われていたが、やがて膜厚均一性や膜質の観点から減圧CVDが使われるようになった。 |
||||||||||
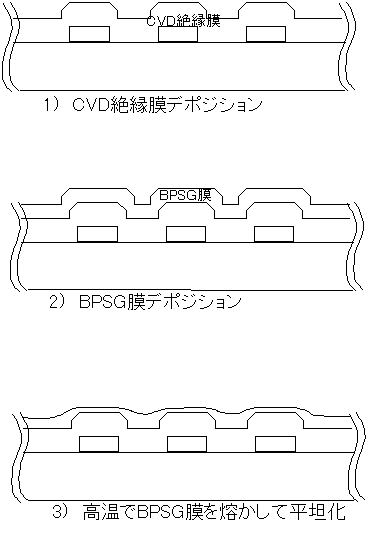 図 BPSGによるリフロー平坦化工程 |
||||||||||
|
【参考文献】 1) S.M.Sze 「VLSI Technology」1983 2) 原央 編 アドバンストエレクトロニクスシリーズ「ULSIプロセス技術」 【移動ページ】 プロセス技術/該当年代へ 【最終変更バージョン】 rev.000 2010/12/3 |