|
|
||||||||||
1980年代 プラズマCVD(低温SiO2/SiN)主流 〜プロセス技術〜 |
||||||||||
| 1980年代に入り微細化による配線への熱の影響が顕著になりはじめ、海外装置メーカーよりSiNパッシベーション用に低温化したプラズマCVDが販売され始めた。SiN膜はポリイミドや低温SiO2膜(LTO)などに比べて耐湿性が高く、パッシベーション機能に優れていたがプラズマを利用しない減圧CVDでは500度以上の高温が必要であった。その為、メタル配線後のパッシベーション工程では400℃前後までの低温化が可能なプラズマCVDが積極的に取り入れられた。日本エー・エス・エムではいち早く国産化を開始、当時の横型減圧CVDにプラズマ機能を取り入れたバッチ式プラズマCVD装置が一世を風靡した。 その後、プラズマCVDの応用は低温SiO2膜に広がり、層間絶縁膜としても使われるようになった。 同時に、TEOS(テトラエトキシシラン)の供給量拡大と共にプラズマTEOS SiO2が開発され、枚葉プラズマCVD装置の採用が進んだ。1987年にはマルチチャンバープラズマCVD装置がアプライドマテリアルズから、同じ時期にセミバッチ装置がノベラスから発売された。枚葉プラズマCVD装置は層間絶縁膜の量産用としてはスループットが低かったが成膜レートの急激な向上により、一気にマーケットシェアが拡大した。 結果、減圧CVD装置に続き、プラズマCVDが半導体製造装置の一角として名を連ねる市場に成長し、1990年代には多層化や高密度プラズマによるギャップフィルへと市場が拡大していき、2000年代にはプラズマALD(アトミックレイヤーデポジション)装置も提案されるようになった。 |
||||||||||
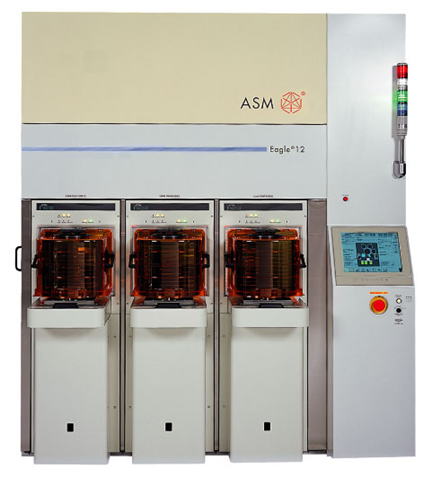 |
||||||||||
| 図1 日本エー・エス・エム 300mm枚葉プラズマCVD 3) | ||||||||||
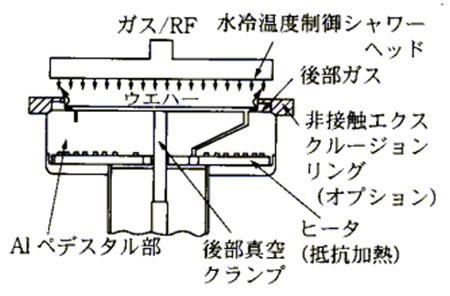 |
||||||||||
| 図2 プラズマCVD装置の構造例(チャンバー部分)4) |
||||||||||
|
【参考文献】 1)SEAJ 創立20周年社団法人化10周年記念誌 2) はじめての半導体製造装置(1999年3月10日)、前田和夫著、 3) 「はじめての半導体製造装置」、(1999年3月10日)、前田和夫著、(株)工業調査会発行、145頁、図5.23(a) 【移動ページ】 プロセス技術/該当年代へ 【最終変更バージョン】 rev.001 2013/7/30 |