|
|
||||||||||
1984年 ノン・ラッチ・アップIGBTの発明(東芝) 〜個別半導体・他〜 |
||||||||||
| 1984年東芝(株)の中川明夫が、ノンラッチアップ形IGBTを発明、これを発表した。 東芝は、1986年、このデバイスを商品化、実用的、ノンラッチアップ型IGBTとして発売した。 IGBTは高耐圧パワーMOSFETのオン抵抗値の低減を目的に、1980年RCAのH.W. Backe, C.F. Wheatlyが基本的IGBTの構造を示し、次いで、GEのBaligaが最初に試作して、その結果を、1982年に発表したデバイスである。MOSFETは、ゲートドライブが容易であり、破壊し難く、スイッチング周波数を高く設定できるので、システムの小型化が容易である。しかし、MOSFETはユニポーラ形デバイスである為、高耐圧化に伴い、オン抵抗値が急速に増加する欠点を持ち、大電力化に制約があった。この欠点を改善したのがIGBTである。 図1にパワーMOSFETの断面図、図2にIGBTのそれを示す。通常のMOSFETがチップ裏面のドレイン側にn+層を持つのに対し、IGBTはp+層を持つ。NチャンネルMOSFETがキャリアとして、電子のみを利用するのに対し、IGBTは、p+層からn-層に正孔を注入する事で、電子、正孔の両キャリアを利用した伝導変調効果が利用出来、n-層の抵抗値を低下させる事が出来る。この様にして高耐圧MOSFETのオン抵抗値の低減が可能となった。 但し、図2に示す様に、このデバイスはサイリスタと同様、pnpnの4層構造である。この為、ラッチアップ現象を容易に引き起こし、破壊するので、実際に応用するのは難しかった。この問題を解決して、応用範囲を驚異的に広げたのが、中川の発明によるノンラッチアップ型IGBTである。図3の様に、IGBTのエミッタをストライプ構造とし、エミッタのn+領域の一部を周期的に削除し、かつ、チャンネル長を適正化する事で、過大な飽和電流を抑え、加えて、正孔の流出経路の拡大とにより、ラッチアップ耐量を大幅に向上し、大電流化に成功した。IGBTはその後、世代を重ね、トレンチゲート、薄ウエハーPT(Punch Through)、FS (Field Stop) 構造などの採用で、オン抵抗の低減と、スイッチング速度のトレードオフを更に向上させる。スイッチング周波数の高周波化により、システムの静音化、小型化が可能となった。更に、並列動作が容易である為、モジュール構造:PM(パワーモジュール)を利用する事で、大電力化を達成。1989年には、制御・保護機能を持つIC チップを搭載した、IGBT-IPM(インテリジェントパワーモジュール)を三菱が開発し、更に、破壊し難く、使い易いデバイスへと発展した。 現在、IGBTはインバータ用に最適なデバイスとして、エアコン、洗濯機、冷蔵庫、IH調理器などの白物家電、エレベータ、ロボット、工作機等の産業用、さらに電気自動車など、広範囲に利用されている。 |
||||||||||
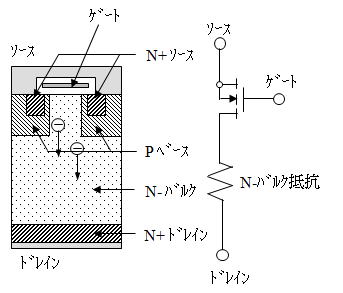 図1 MOSFETの等価回路と構造図 |
||||||||||
 図2 IGBTの等価回路と構造図 |
||||||||||
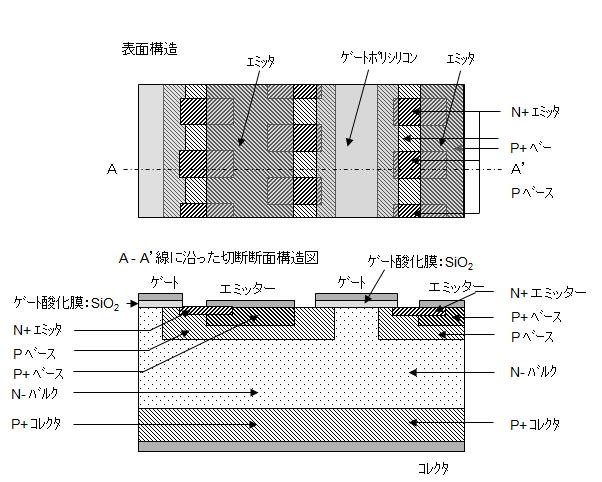 図3 ノンラッチアップIGBT構造図 |
||||||||||
 写真1 東芝が最初に発売した、ノンラッチアップ形IGBT(東芝提供) |
||||||||||
| 【参考文献】 (1) A. Nakagawa et al., “Non-Latch-Up 1200V, 75A Bipolar-Mode MOSFET with Large SOA", IEEE IEDM Digest of Technical Papers, pp. 860-861 (1984) (2) “バイポーラ形MOS FET(IGBT)”東芝レビュー(41巻4号)p. 341 (1986) (3) B.J. Bariga et al. “The Insulated Gate Rectifier: A New Power Switching Device,” IEEE IEDM Digest of Technical Papers, pp.264-267 (1982) (4) G. Majumdol, et al. “A New Series of Smart Controllers”, IEEE-IAS, pp. 1356-1362 (1989) (5) B. Jayant Baliga, Fundamentals of Power Semiconductor Devices, Springer, (2008) (6) IGBT 図書企画編集委員会編“世界を動かすパワー半導体”電気学会, (2008年12月) (7) 大野栄一編“パワーエレクトロニクス入門” オーム社, (1984年5月) |
||||||||||
| 【移動ページ】 個別半導体他/該当年代へ |
||||||||||
| 【最終変更バージョン】 rev.001 2015/7/6 |