1970年代
プロキシミティ露光装置およびプロジェクション露光装置
〜装置・材料/リソグラフィ〜
コンタクト露光方式[1][2]はフォトマスクをフォトレジストが塗布されたシリコンウェーハに密着させるため、フォトマスクへの傷や異物付着により消耗が激しかった。また微細加工レベルが5μmから3μmへと進むに際して解像度向上が必要になったが、クロムマスク製作に使われた解像度に優れたポジ型レジスト[3]は脆性が高いノボラック樹脂であり、密着露光では損傷しやすいために使用できなかった。この主にふたつの欠点を解消するために、フォトマスクをウェーハから離して露光するプロキシミティ露光方式やプロジェクション露光方式が開発された[4]
。本方式の始りは1970年にキヤノンが開発した等倍投影するPPC-1である(図1)[5]。この方法はウェーハとフォトマスクの距離を10〜20μmとするプロキシミティ露光装置として発展し、1974年にキャスパーとキヤノン(PLA-300F)から発売された。プロキシミティ露光方式の解像度は4μm程度でコンタクト露光の0.5μmより劣るが、5μmプロセス近傍までの歩留を大幅に向上させた。1977年にキヤノンはさらに世界初のレーザースキヤンオートアライメント機構を搭載したPLA-501FAを発売した(図2)。以後、アライナーは自動化方式になっていった。歩留や生産性を、作業者の熟練度に依存せずに大幅に向上させた。
フォトマスクをウェーハから離したときに解像度が低下する欠点を補う方式には、凸面鏡と凹面鏡を組み合わせて円弧上の視野を持つ光学系を用い、フォトマスクとウェーハを同時に走査させてウェーハ前面に露光させる等倍投影型のプロジェクション露光方式が登場した[6]
。この露光装置は1973年にパーキン・エルマーから発売された。当初の解像度は2.5μmであった。
こうして70年代後半の3μm〜2μmプロセスでは、ポジ型レジストによるプロキシミティやプロジェクション露光方式が主流となった。
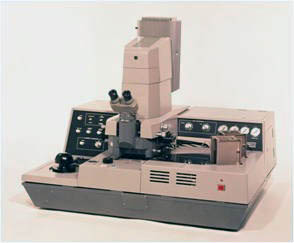
図1 最初のプロジェクション露光装置PPC-1 (写真提供;キヤノン)

図2 自動位置合わせプロキシミティ露光装置PLA-501FA) (写真提供;キヤノン)
【参考文献】
[1] 1960年代:コンタクト方式リソグラフィ技術によるシリコンデバイスの製造
[2] 1960年代: コンタクト露光装置
[3] 1970年代後半:ポジ型フォトレジスト
[4] 1970年代中頃:リソグラフィー技術がコンタクト露光方式からプロキシミティ露光方式へ移行
[5] キヤノン「イメージング開拓史」
[6] 1970年代後半:リソグラフィ分野でプロジェクション・アライナーが登場
[移動ページ]
■ 装置材料 該当年代へ
■歴史館の他のページへ
| HOME | ようこそ | 業界動向
| 応用製品 | 集積回路 |
個別半導体他 | プロセス技術
|
| パッケージング技術 | 装置・材料
|
[最終変更バージョン]
Ver.002 2019/12/18
