|
|
||||||||||
1994擭 俠俽俹偺MCM偵懳偡傞桪埵惈傪庡挘 乣僷僢働乕僕儞僌乣 |
||||||||||
| 1994擭俈寧18擔丂擔棫惢嶌強偼俽俤俵俬俠俷俶 倂倕倱倲偵暪愝偟偰奐嵜偝傟偨俬値倲倕倰値倎倲倝倧値倎倢 俹倎們倠倕倗倕 Roadmap Workshop偵偍偄偰丄俵俠俵乮俵倳倢倲倝
俠倛倝倫 俵倧倓倳倢倕)幚憰曽幃傗俲俧俢乮俲値倧倵値 俧倧倧倓 俢倝倕乯傛傝丄愝寁帺桼搙偑崅偔丄埨壙偵惢憿偱偒丄怣棅惈傕妋曐偝傟傞僷僢働乕僕偲偟偰丄俠俽俹乮俠倛倝倫
俽們倎倢倕 俹倎們倠倎倗倕乯偑壙奿柺丒怣棅惈柺丒惗嶻惈丒墳梡柺側偳偱桳棙偱偁傞偙偲傪敪昞偟偨丅俠俽俹偺奣擮偼丄俴俽俬慺巕婡擻傪嵟彫奜宍宍忬偱幚尰偝偣傞偙偲偵傛傝丄傛傝崅枾搙側幚憰偑幚尰偝傟傞偙偲傪愢柧偟偨丅俠俽俹悺朄偼丄慺巕悺朄斾侾丏係攞埲壓丄柺愊2攞埲壓傪俠俽俹偲屇傃偙偲側偳傕採埬偟偨丅俢俼俙俵偺LOC乮Lead
On Chi倫乯峔憿偺俽俷俰丄俿俽俷俹傗戝宆寁嶼婡梡MCC乮Micro Chip Carrier(側偳偑偦傟偵摉偨傞偲偟偨丅 壓恾偼偦偺帪偺堦晹帒椏偱偁傞丅偙偺敪昞偵屻丄悽奅奺幮偐傜懡偔偺彫宆奜宍僷僢働乕僕偑奐敪偝傟偨丅晉巑捠幮偐傜偼俛俠俠乮俛倳倣倫倕倓 俠倛倝倫 俠倎倰倰倝倕倰乯丆徏壓揹巕晹昳幮偐傜偼俻俥俶乮俻倳倎倓 俥倢倎倲 俶倧値亅俴倕倎倓乯丄壂揹婡側偳偐傜偼倂俴俠俽俹丄擔棫嬥懏偐傜偼俶倝揹拻傔偭偒傪墳梡偟偨俤俥俹乮俤倢倕們倲倰倧 俥倧倰倣倝値倗 俹倎們倠倎倗倕乯側偳丄暷崙俿倕倱倱倕倰倎幮偐傜偼兪俛俧俙丄俵倝們倰倧俽俵俿幮偐傜偼俥倎値俬値峔憿丄TI幮傗僔儍乕僾幮偐傜偼俿俙俛僥乕僾傪梡偄偨兪俽倲倎倰傗俥俛俧俙丄僩儉僜儞偐傜偼俁俢僾儔僗丄僀僗儔僄儖偺僔僃儖働乕僗幮偐傜偼僈儔僗僷僢働乕僕側偳懡偔偑奐敪偝傟偨丅偙傟傜俠俽俹僷僢働乕僕偼丄実懷宆揹巕婡婍偵嵦梡偝傟丄彫宆壒妝僾儗乕儍乕丄実懷揹榖丄僨僕僇儊側偳偺揹巕婡婍傪惗傒弌偡婎揰偵側偭偨丅 |
||||||||||
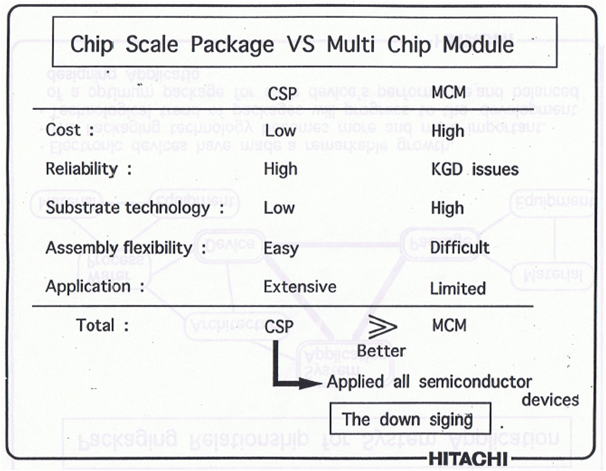 |
||||||||||
|
亂嶲峫暥專亃 Gen Murakami丟乬Semiconductor Packaging Roadmap乭丂Packaging Industry Roadmap to the future, SEMICON WEST1994, July,18. 亂堏摦儁乕僕亃 僷僢働乕僕儞僌/奩摉擭戙傊 亂嵟廔曄峏僶乕僕儑儞亃 2010/10/26 |