|
|
||||||||||
2000年代 高解像度化技術 〜プロセス技術〜 |
||||||||||
| 従来の方法では、露光に用いる光源の波長程度までしか微細化できなかったのに対し、更に解像度を高める技術が開発された。解像度高度化技術の主なものは,①斜入射照明技術,②マスク上での光の位相操作,③マスク上パターンの事前補正,④複雑なパターンの分割加工,等が挙げられる。これら技術の着想は1980年代頃から始まり,微細加工に従事する多くの研究・開発エンジニアにより実用化に向けた取り組みがなされ,1990年代に部分的に実用化されていった。ArFの次の露光光源が不透明な中,現在もよりいっそう高度な微細化技術に対する取り組みがなされている。
①はマスクを斜めから照明し,マスク通過後両側に広がる回折光のうち,片側の分は捨て,2光束で結像してもう片側が少しでも多くレンズに取り込めるようにして,焦点深度を深くするための工夫である。装置としては照明絞り開口部の最適配置周辺部のみの光を透過するフィルターを挿入することで実現される(図.1)。 |
 |
|||||||||
図1 斜入射照明法
| ||||||||||
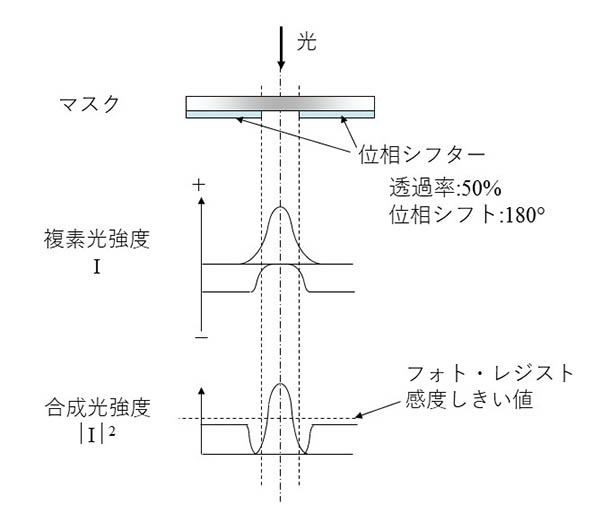 |
||||||||||
| 図2 ハーフトーン型位相シフト法 | ||||||||||
|
【参考文献】 【移動ページ】 プロセス技術/該当年代へ 【最終変更バージョン】 rev.000 2010/10/26 |