|
|
||||||||||
1997年 BCC量産開始 〜パッケージング〜 |
||||||||||
| BCC(Bump Chip Carrier)は、富士通社により開発されたパッケージで、1997年1月より16ピンタイプが量産化された。製法はリードフレームに凹部を設けAu→Pd→Ni→Pdのめっきを行い、ICなどの素子をダイボンディングとワイヤーボンディングを行い、トランスファーモールド成型後、リードフレームをエッングにより取り除きCSP(Chip Scale Package)を完成させるものである。下図左側がBCC構造の断面構模式図で、右図はボンディング後のSEM写真である。 BCCは小型であることからセルフインダクタンスやキャパシタンスがSSOP比で、夫々25%と80%の削減を達成するなど、通信系デバイスなどに向いていて、携帯電話など素子に適用された。 |
||||||||||
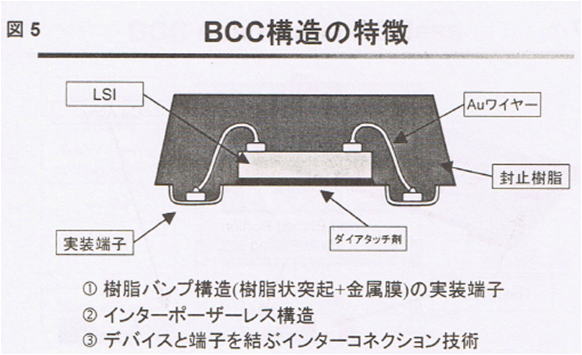 |
||||||||||
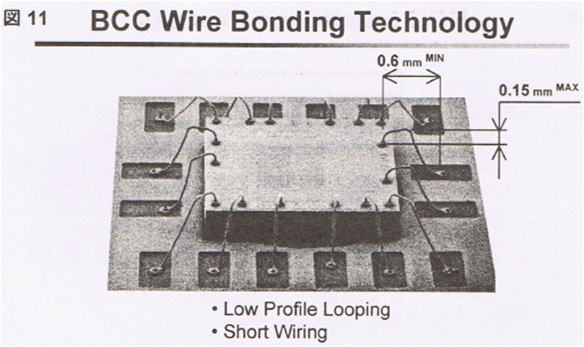 |
||||||||||
|
【参考文献】 米田義之;「富士通BCC技術の開発状況」’98ULSIパッケージ新技術シンポジウム 各社CSP化最新技術と今後の動向, 半導体パッケージ技術研究会 ISS産業科学システムズ 【移動ページ】 パッケージング/該当年代へ 【最終変更バージョン】 2010/10/26 |