1972年
電界放射型走査型電子顕微鏡(FE-SEM)
〜装置・材料/計測・検査〜
微細な立体構造が観察可能な走査型電子顕微鏡(Scanning Electron Microscopy : SEM)の原型は1936年にベルリン工科大学のMax
Knollによって考案された。1965年にCambridge Scientific Instrument Companyによって初めて商用機として実用化された(Stereoscan
MK1)[1]。 日本では1966年に日本電子(JSM-1)が、1969年には日立がHSM-2の販売を開始した。1970年代以降のLSIの製造技術開発では、デバイスの微細な構造解析や微小な塵埃などの電子顕微鏡レベルの解析が不可欠となり、SEMはその有力ツールとなった。
1972年、日立(現日立ハイテクノロジーズ)はChicago Universityと共同して電界放射型(Field Emission)電子線源を用いたSEM(FE-SEM)を開発し、発売した(FES-2、図1)[2]。
先端を極細に研磨したタングステンを陰極として高電界を印加し、エネルギーばらつきの小さい高輝度の電子を発生させる電子線源であり、これにより3ナノメータ―の高分解能を実現したものである。この電子線源の原理は1968年にChicago
UniversityのAlbert V. Creweによって考案された[3]。
FE-SEMは様々な分野での微細構造分析に使われるようになったが、比例縮小を続ける半導体のデバイス・プロセスにおいても不可欠なツールとなった。その後も分解能の向上が進められ、1980年代には半導体の微細寸法を計測するCD-SEM[4]にも使われるようになった。
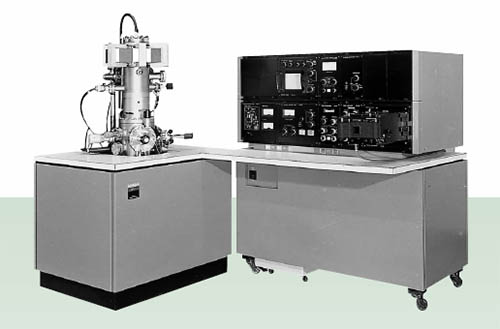
図1 FE-SEM FES-2 (日立ハイテクノロジーズ提供)
【参考文献】
[1] Cambridge
Scientific Instrument Company - Wikipedia
[2] the
institute “Field Emission Scanning Electron Microscope Earns Milestone”
[3] イノベーション100選 電界放射型電子顕微鏡
[4] 半導体歴史館:1980年代 測長SEM
[移動ページ]
■ 装置材料 該当年代へ
■歴史館の他のページへ
| HOME | ようこそ | 業界動向
| 応用製品 | 集積回路 |
個別半導体他 | プロセス技術
|
| パッケージング技術 | 装置・材料
|
[最終変更バージョン]
Ver.002 2019/12/18
