|
|
||||||||||
2015年 FOWLP (Fan-Out Wafer Level Package)技術の開発活発化 (Infineon、TSMC、他各社) ~パッケージング技術~ |
||||||||||
FOWLP (Fan-Out Wafer Level Package)はICチップ上に形成された微細な再配線 (RDL: Redistribution Layer)が、チップの外形より外側に拡張されて形成されている構造のパッケージで、これにより複数のチップ間を高密度な配線で形成する事や、 従来のパッケージと比較して大幅な小型・薄型化が実現できる。配線の製造プロセスに従来のシリコンウェハ上の配線に用いられていた 薄膜プロセスを適用することで、微細化を実現している。 TSV (Through Silicon Via)技術は、チップ間の高密度接続技術、特にプロセッサへの広帯域メモリ接続技術として期待されているものの、 現状では高い追加コストがネックになり、一部のHPC (High Performance Computing)用途への適用に留まっている。一方、FOWLP (Fan-Out Wafer Level Package)は2000年代の後半にInfineonの”eWLB” (embedded Wafer Level Ball Grid Array)などがOSAT (Outsource Assembly and Test)各社にライセンスされ実用化していたものの、技術的な制約により一部の高周波ICや、 ベースバンドチップ等への適用に留まっていた。 しかし2014年頃からFOWLPの技術制約を克服し、さらに高機能なチップへの適用に向けた動きが目立ち始め、2015年にはAppleの iPhone向けアプリケーション・プロセッサにFOWLPの一種であるTSMCの”InFO” (Integrated Fan-Out)技術を適用するという報道がされた。eWLBでは、RDL形成を再構成ウェハと呼ばれるチップを埋め込んだ 樹脂のウェハに対して行っていたのに対し、InFOでは、RDL形成をウェハ上で処理することによりチップと再配線のアライメント精度を向上、 端子数の多いアプリケーション・プロセッサにも適用できるようにしている点が特徴。エレクトロニクスの巨大市場であるモバイル製品への適用は、 FOWLPの市場拡大と技術汎用化の大きな原動力となると考えられ、現在、多くのファウンダリ、OSAT (Outsourced Semiconductor Assembly and Test)、装置/材料メーカの参入で、TSVのアプリケーションと考えられていたハイエンドの製品にも 適用できるような高密度集積技術としてのFOWLPの開発が活発化している。 日本においてもeWLB等と同時期の2000年代に異なる方式のFOWLP技術の研究開発が行われていた。 NEC/NECエレクトロニクス/ルネサスエレクトロニクスのRDL-1st方式のFOWLP技術で、eWLBやInFOのChip-1st方式と異なり、 さらなるRDL微細化やTSV積層技術との組み合わせが可能であることを特徴としている。RDL-1st方式は次世代のFOWLP技術として 期待されており、各社で開発が進められている。 |
||||||||||
 |
||||||||||
図1 FOWLP外観(ASE 提供)
|
||||||||||
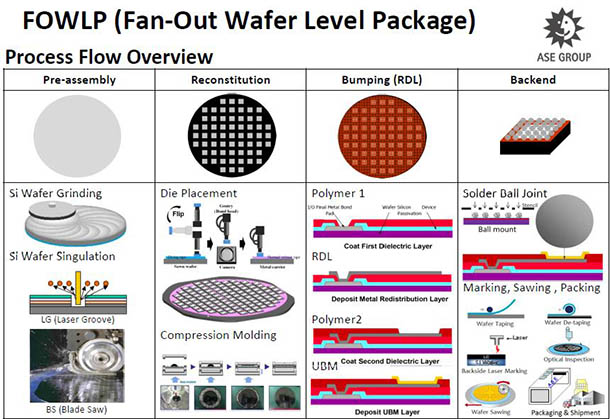 |
||||||||||
図2 一般的なChip-1st方式FOWLPのプロセスフロー(ASE 提供)
|
||||||||||
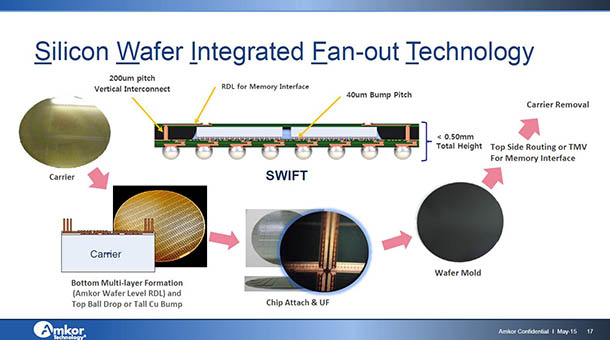 |
||||||||||
図3 RDL-1st方式FOWLPの例(Amkor 提供)
|
||||||||||
|
【参考文献】 [1] http://www.sangyo-times.jp/article.aspx?ID=1381 [2] http://techon.nikkeibp.co.jp/article/COLUMN/20150421/415300/ [3] http://www.sangyo-times.jp/article.aspx?ID=1699 [4] http://www.statschippac.com/documentlibrary/ewlb.pdf [5] http://community.cadence.com/cadence_blogs_8/b/breakfast-bytes/archive/2015/11/30/cowos-info?pi1240=2 [6] http://semimd.com/insights-from-leading-edge/2011/07/22/iftle-59-thin-film-polymer-apps-from-the-2011-ectc-tezzaron-3d-activity/ [7] http://www.3dincites.com/wp-content/uploads/slim-swift-customer-overview-may-13-2015.pdf 【移動ページ】 パッケージング技術該当年代へ 【最終変更バージョン】 rev.001 2016/7/27 |